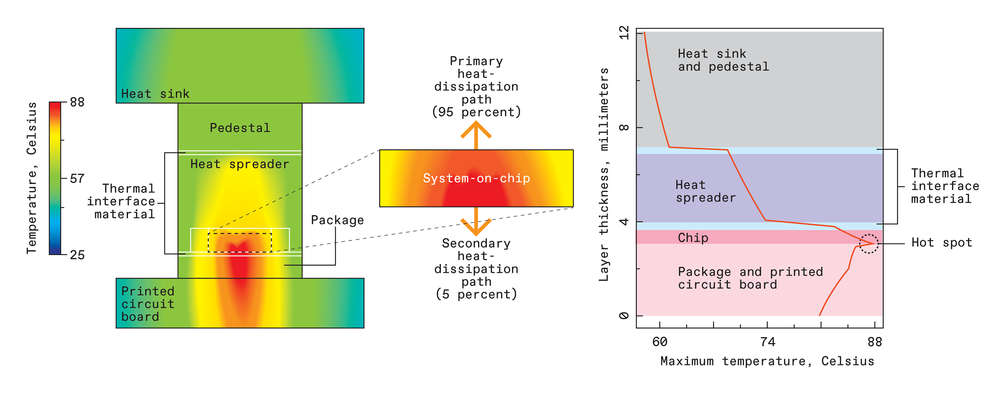 在5年以上,工程师设法在摩尔法律驱动的情况下,每两年封装一次在同一地区封装的晶体管数量增加一倍。但是,随着行业追求逻辑密度,不愉快的效果变得越来越好 - 已知:热量。本文指出:在CPU和GPU等片上(SOC)中,温度会影响性能,消耗和能源效率。随着时间的流逝,过多的热量会减慢关键处理器信号的传播,并导致芯片性能永久下降。这也会导致晶体管泄漏更多的电流,从而浪费功率。在这方面,增加电消耗可能会削弱芯片能源效率,因为执行完全相同的能量。问题的根源在于另一个法律的末尾:丹纳德缩放。该法律指出,随着晶体管的线性尺寸降低,必须降低电压,以使给定区域的总电量保持不变。GED。如果不影响整体晶体管功能,则在2000年代中期有效地完成了丹纳德缩放率,如果无法进一步降低电压。因此,即使逻辑回路的密度继续增长,功率密度也会增加,形成热量作为副产品。随着芯片变得更加紧凑和强大,预防良好的热量对于维持性能和使用寿命很重要。为了确保这种效率,我们需要一种工具来预测新的半导体技术(产生晶体管,互连和逻辑细胞的过程)如何改变热量的形成和去除方式。 IMEC研究同事和我开发了它。我们的仿真框架使用工业标准和开源电子设计自动化(EDA),并增强了我们的内部工具设置,以快速探索半导体技术与使用它开发的系统之间的相互作用。到目前为止,结果是不可避免的:热挑战的增加对于每个新技术节点,我们都需要新的解决方案,包括设计芯片和系统的新解决方案,如果他们希望能够应对热量。传统上,冷却极限是通过通过连接到包装的散热器开花空气来冷却SOC的。一些数据中心开始使用液体,因为它吸收的MAS比气体要多得多。液体冷却剂(通常是水基或水基混合物)可能适用于最新一代的高性能芯片,例如NVIDIA的新AI GPU,据报道,该芯片可消耗多达1,000瓦的功率。但是,风扇或液体冷却可能与即将到来的较小节点技术相匹配。当去除芯片的热量时,会遵循复杂的路径,但其中95%通过设备排放。 IMEC捕获了现场效应(CFET)中的纳米片晶体管和辅助晶体管。顶级芯片制造商转向纳米芯片设备,该设备将鳍转换为当今现场的晶体管效应一堆水平的半导体芯片。 CFET将这种体系结构带到了极端,并用Patayo堆叠了更多的床单,并将两个设备分开,从而使两个晶体管与晶体管大致相同。专家预计,半导体行业将在2030年代引入CFET。在我们的工作中,我们查看了即将到来的Nanosheet A10版本(指10 angstrom或1 nm节点)和一个名为A5的CFET版本,IMEC希望在A10之后出现两代人。我们测试设计的仿真表明,A5节点的功率密度比A10节点高12%至15%。在相同的工作电压下,增加该密度将导致9°C的估计温度升高。晶体管的完整作用覆盖了彼此上方的纳米片晶体管,从而增加了密度和温度。要在类似于纳米片晶体管(A10节点)的相同温度下操作,CFET(A5节点)应在还原的电压下运行年龄。 IMEC Company 9学位可能不会太多。但是,在数据中心,将数千至数百万芯片包裹在一起的数据中心,这可能意味着稳定操作和热失控之间的差异,即可怕的反馈回路,温度增加泄漏,温度升高,以防止永久损害。研究人员正在寻找基本液体和冷却空气的先进替代品,以帮助缓解极端的高温。例如,微流体冷却使用与芯片绑定的小通道来旋转设备内的液体冷却液。其他程序包括喷气撞击,包括在芯片上高速的气体或Likido,并冷却浸入,将整个印刷电路板浸入冷却液浴中。但是,即使这些新技术开始起作用,只依靠冷却器释放过多的热量可能并不实际。对于仅限尺寸,重量,蝙蝠的移动系统尤其如此ry力量,不需要用户烹饪。同时,数据中心面临着各种限制:由于冷却是整个建筑物基础设施的成本,因此每次到达新芯片时更新冷却的冷却,它非常昂贵且非常具有破坏性。与热量相比,性能与幸运的是,冷却技术并不是阻止炸薯条油炸的唯一方法。各种系统级解决方案可以通过动态新的适应变化的热条件来控制热量。一种方法是将热传感器放置在芯片周围。当传感器检测到升高温度的升高时,它们会释放出降低电压和工作频率的信号,从而降低电力消耗以抵消热量。但是,尽管这样的解决方案解决了散热问题,但它可能会显着影响芯片性能。例如,芯片在热环境中总是可以效果不佳,例如任何人放置智能的证据白天。另一种称为Hot Sprint的技术对于多核数据中心CPU特别有用。这是通过运行核心直到过热的核心来完成的,然后在第一个核心冷却时将其移至第二核。这个过程是xtimime的性能,但是当任务应在许多内核之间移动以执行更长的活动时,可能会导致延迟。热冲刺也减少了整体芯片吞吐量,因为冷却时芯片的某些部分总是被禁用。因此,系统级解决方案需要在热量和性能之间进行仔细的平衡。为了有效地应用它们,SOC设计师必须对芯片中的功率分布,热点出现,传感器的放置位置,电压或频率降低的位置以及某些芯片零件冷却所需的时间。但是,即使是最好的芯片设计师,也很快就需要更具创意的方法SA热门管理。有希望偷走的意图他的芯片背面包括在晶圆的底部或背面添加新功能。这种方法主要旨在改善电力传递和计算性能。但这也可以帮助解决一些卡路里问题。新技术可以降低需要传递到多核处理器的电压,从而使芯片在以可接受的频率运行时保持最小电压。背面动力网络通过降低电阻来做到这一点。后电容器减少了瞬态电压损耗。后部允许根据需要在不同最小电压下运行的不同芯的组合调节器。 IMEC公司IMEC遇到了许多后方技术,这些技术可能使芯片与较低的Bointage一起工作,从而减少了它们的热量。路线图中的第一个技术是So值的后端电源网络(BSPDN),该技术的名称可以:它将电源线从芯片的前端移动到后方。所有高级CMOS铸造计划在2026年底之前提供BSPDN。先前的示威活动表明,它们通过将电源更接近晶体管来降低阻力。电阻越小,电压损耗越小,这意味着芯片可以用降低的输入电压工作。当电压降低时,功率密度降低并且温度下降。通过更换散热路径上的材料,后递送技术可以使芯片中的热点更热。 IMEC在BSPDN之后,制造商可以添加具有高储能容量的电容器。在高性能的SOC中,由印刷电路板和芯片包上的电感引起的大电压波可能是有问题的。重新塑造电容器应帮助解决此问题,因为它们靠近晶体管,使它们能够吸收电压尖峰并更快地变化。因此,这种布置将提供芯片以在较低的电压和温度下运行,而仅比BSPDN使用。最后,芯片制造商WILL启动后部集成电压调节器(IVR)电路。该技术旨在通过调整更优惠的电压来进一步降低芯片电压需求。例如,用于智能手机的SOC通常具有8个或MORECOUTE的内核,但是没有芯片室可以拥有自己的离散调节器。取而代之的是,不管所有四个芯都面对相同的计算负载,片外调节器通常会一起管理四个芯的电压。另一方面,IVR将通过专用电路来管理每个核心统一,从而能量能量。将它们放在后面可以节省重要的前部空间。目前尚不清楚技术如何影响热管理;需要示范和仿真来绘制渲染。添加新技术通常会增加电力密度,而芯片设计人员需要考虑热后果。例如,将后部IVR放置时,如果IVR分布在Nequal等效上,或者如果它们集中在某个位置(SUC),则热问题会改善H作为每个核心和缓存内存的中心)?最近,我们已经表明,即使解决了旧的热问题,也可以引入强度的后备引入新的热问题。原因是创建BSPDN时留下的硅层变得越来越薄。在前设计中,硅基板的厚度可以达到750微米。由于硅具有良好的导热率,因此该相对压倒性的层通过横向分散晶体管的热量来帮助控制热区域。但是,将技术添加到后部需要将基板变薄至约1μm,以便从后部与晶体管相互作用。在两层电线和绝缘子之间刮擦,这种细长的硅晶片不再有效地将热量移至两侧。因此,超级活性晶体管的热量可以在本地捕获并强迫向上冷却,从而使热区域恶化。我们对80核服务器SOC的模拟发现,BSPDN可以提高热点温度E最高可达14°C。设计和技术调整(例如增加背部金属密度)可以改善这种情况,但是我们需要更多的疏远技术来完全防止它。准备“ CMOS 2.0” BSPDN是SO符合的硅逻辑技术新范式的一部分。这个新兴时期还将看到高级晶体管体系结构和专用逻辑层。这些技术的主要目的是优化芯片性能和功率效率,但它们还可以提供热销售,包括改善散热量。在当今的CMOS芯片中,单个晶体管向相邻和远处的组件驱动信号,从而导致无能。但是,如果有两层驱动器怎么办?一层将处理长线并使用专用晶体管缓冲这些连接;其他人只会处理低于10μm的连接。因为第二层中的晶体管将针对短连接进行优化,所以它们可以在较低的电压下运行,这将红色UCE电密度。但是,确切的值仍然不确定。将来,芯片成分将使用适合每个芯片的技术过程来处理自己的硅晶片。那么,只能仅使用P ProcationUrerInpon构建的SOC就能产生更好的SOC。但是工程师应仔细考虑热量如何流入新的3D结构。对于公司而言,解决该行业热量问题的IMEC是什么是跨学科的努力。没有技术(如果是热接口材料,晶体管,系统控制解决方案,包装或冷却器)可能会解决未来芯片的热问题。我们将需要所有这些。借助良好的仿真工具和评估,我们可以开始了解每个过程的应用量以及如何应用程序。尽管CMOS 2.0技术的热优点(尤其是背部和专注逻辑)似乎有望确认这些早期预测并仔细评估它们影响。例如,对于后技术,我们需要确切地了解它们是否会改变产生和散热,并且是否会产生更多的新问题。芯片设计人员可能倾向于采用新的半导体技术,因为以后可以在软件中处理意外的热问题。这可能是正确的,但是在一定程度上。由于这些解决方案自然不准确,因此过度依赖软件解决方案会影响芯片性能。例如,修复单个热点可能需要对较大区域的性能损害,否则较大的区域。用于建造它们的SOC和半导体技术应该在一起。好消息是,更多的EDA产品为先进的热分析增加了功能,包括芯片设计的早期阶段。专家还要求采取新的芯片开发策略,称为系统技术合作。 STCO旨在通过考虑系统,物理设计和过程技术来消除它们之间严格的抽象界限以全面的方式。深入的专家必须离开舒适区,并与其他芯片工程领域的专家合作。我们可能还不知道如何应对该行业更严重的热门挑战,但是我们对正确的工具和协作感到乐观,这可以做到。
在5年以上,工程师设法在摩尔法律驱动的情况下,每两年封装一次在同一地区封装的晶体管数量增加一倍。但是,随着行业追求逻辑密度,不愉快的效果变得越来越好 - 已知:热量。本文指出:在CPU和GPU等片上(SOC)中,温度会影响性能,消耗和能源效率。随着时间的流逝,过多的热量会减慢关键处理器信号的传播,并导致芯片性能永久下降。这也会导致晶体管泄漏更多的电流,从而浪费功率。在这方面,增加电消耗可能会削弱芯片能源效率,因为执行完全相同的能量。问题的根源在于另一个法律的末尾:丹纳德缩放。该法律指出,随着晶体管的线性尺寸降低,必须降低电压,以使给定区域的总电量保持不变。GED。如果不影响整体晶体管功能,则在2000年代中期有效地完成了丹纳德缩放率,如果无法进一步降低电压。因此,即使逻辑回路的密度继续增长,功率密度也会增加,形成热量作为副产品。随着芯片变得更加紧凑和强大,预防良好的热量对于维持性能和使用寿命很重要。为了确保这种效率,我们需要一种工具来预测新的半导体技术(产生晶体管,互连和逻辑细胞的过程)如何改变热量的形成和去除方式。 IMEC研究同事和我开发了它。我们的仿真框架使用工业标准和开源电子设计自动化(EDA),并增强了我们的内部工具设置,以快速探索半导体技术与使用它开发的系统之间的相互作用。到目前为止,结果是不可避免的:热挑战的增加对于每个新技术节点,我们都需要新的解决方案,包括设计芯片和系统的新解决方案,如果他们希望能够应对热量。传统上,冷却极限是通过通过连接到包装的散热器开花空气来冷却SOC的。一些数据中心开始使用液体,因为它吸收的MAS比气体要多得多。液体冷却剂(通常是水基或水基混合物)可能适用于最新一代的高性能芯片,例如NVIDIA的新AI GPU,据报道,该芯片可消耗多达1,000瓦的功率。但是,风扇或液体冷却可能与即将到来的较小节点技术相匹配。当去除芯片的热量时,会遵循复杂的路径,但其中95%通过设备排放。 IMEC捕获了现场效应(CFET)中的纳米片晶体管和辅助晶体管。顶级芯片制造商转向纳米芯片设备,该设备将鳍转换为当今现场的晶体管效应一堆水平的半导体芯片。 CFET将这种体系结构带到了极端,并用Patayo堆叠了更多的床单,并将两个设备分开,从而使两个晶体管与晶体管大致相同。专家预计,半导体行业将在2030年代引入CFET。在我们的工作中,我们查看了即将到来的Nanosheet A10版本(指10 angstrom或1 nm节点)和一个名为A5的CFET版本,IMEC希望在A10之后出现两代人。我们测试设计的仿真表明,A5节点的功率密度比A10节点高12%至15%。在相同的工作电压下,增加该密度将导致9°C的估计温度升高。晶体管的完整作用覆盖了彼此上方的纳米片晶体管,从而增加了密度和温度。要在类似于纳米片晶体管(A10节点)的相同温度下操作,CFET(A5节点)应在还原的电压下运行年龄。 IMEC Company 9学位可能不会太多。但是,在数据中心,将数千至数百万芯片包裹在一起的数据中心,这可能意味着稳定操作和热失控之间的差异,即可怕的反馈回路,温度增加泄漏,温度升高,以防止永久损害。研究人员正在寻找基本液体和冷却空气的先进替代品,以帮助缓解极端的高温。例如,微流体冷却使用与芯片绑定的小通道来旋转设备内的液体冷却液。其他程序包括喷气撞击,包括在芯片上高速的气体或Likido,并冷却浸入,将整个印刷电路板浸入冷却液浴中。但是,即使这些新技术开始起作用,只依靠冷却器释放过多的热量可能并不实际。对于仅限尺寸,重量,蝙蝠的移动系统尤其如此ry力量,不需要用户烹饪。同时,数据中心面临着各种限制:由于冷却是整个建筑物基础设施的成本,因此每次到达新芯片时更新冷却的冷却,它非常昂贵且非常具有破坏性。与热量相比,性能与幸运的是,冷却技术并不是阻止炸薯条油炸的唯一方法。各种系统级解决方案可以通过动态新的适应变化的热条件来控制热量。一种方法是将热传感器放置在芯片周围。当传感器检测到升高温度的升高时,它们会释放出降低电压和工作频率的信号,从而降低电力消耗以抵消热量。但是,尽管这样的解决方案解决了散热问题,但它可能会显着影响芯片性能。例如,芯片在热环境中总是可以效果不佳,例如任何人放置智能的证据白天。另一种称为Hot Sprint的技术对于多核数据中心CPU特别有用。这是通过运行核心直到过热的核心来完成的,然后在第一个核心冷却时将其移至第二核。这个过程是xtimime的性能,但是当任务应在许多内核之间移动以执行更长的活动时,可能会导致延迟。热冲刺也减少了整体芯片吞吐量,因为冷却时芯片的某些部分总是被禁用。因此,系统级解决方案需要在热量和性能之间进行仔细的平衡。为了有效地应用它们,SOC设计师必须对芯片中的功率分布,热点出现,传感器的放置位置,电压或频率降低的位置以及某些芯片零件冷却所需的时间。但是,即使是最好的芯片设计师,也很快就需要更具创意的方法SA热门管理。有希望偷走的意图他的芯片背面包括在晶圆的底部或背面添加新功能。这种方法主要旨在改善电力传递和计算性能。但这也可以帮助解决一些卡路里问题。新技术可以降低需要传递到多核处理器的电压,从而使芯片在以可接受的频率运行时保持最小电压。背面动力网络通过降低电阻来做到这一点。后电容器减少了瞬态电压损耗。后部允许根据需要在不同最小电压下运行的不同芯的组合调节器。 IMEC公司IMEC遇到了许多后方技术,这些技术可能使芯片与较低的Bointage一起工作,从而减少了它们的热量。路线图中的第一个技术是So值的后端电源网络(BSPDN),该技术的名称可以:它将电源线从芯片的前端移动到后方。所有高级CMOS铸造计划在2026年底之前提供BSPDN。先前的示威活动表明,它们通过将电源更接近晶体管来降低阻力。电阻越小,电压损耗越小,这意味着芯片可以用降低的输入电压工作。当电压降低时,功率密度降低并且温度下降。通过更换散热路径上的材料,后递送技术可以使芯片中的热点更热。 IMEC在BSPDN之后,制造商可以添加具有高储能容量的电容器。在高性能的SOC中,由印刷电路板和芯片包上的电感引起的大电压波可能是有问题的。重新塑造电容器应帮助解决此问题,因为它们靠近晶体管,使它们能够吸收电压尖峰并更快地变化。因此,这种布置将提供芯片以在较低的电压和温度下运行,而仅比BSPDN使用。最后,芯片制造商WILL启动后部集成电压调节器(IVR)电路。该技术旨在通过调整更优惠的电压来进一步降低芯片电压需求。例如,用于智能手机的SOC通常具有8个或MORECOUTE的内核,但是没有芯片室可以拥有自己的离散调节器。取而代之的是,不管所有四个芯都面对相同的计算负载,片外调节器通常会一起管理四个芯的电压。另一方面,IVR将通过专用电路来管理每个核心统一,从而能量能量。将它们放在后面可以节省重要的前部空间。目前尚不清楚技术如何影响热管理;需要示范和仿真来绘制渲染。添加新技术通常会增加电力密度,而芯片设计人员需要考虑热后果。例如,将后部IVR放置时,如果IVR分布在Nequal等效上,或者如果它们集中在某个位置(SUC),则热问题会改善H作为每个核心和缓存内存的中心)?最近,我们已经表明,即使解决了旧的热问题,也可以引入强度的后备引入新的热问题。原因是创建BSPDN时留下的硅层变得越来越薄。在前设计中,硅基板的厚度可以达到750微米。由于硅具有良好的导热率,因此该相对压倒性的层通过横向分散晶体管的热量来帮助控制热区域。但是,将技术添加到后部需要将基板变薄至约1μm,以便从后部与晶体管相互作用。在两层电线和绝缘子之间刮擦,这种细长的硅晶片不再有效地将热量移至两侧。因此,超级活性晶体管的热量可以在本地捕获并强迫向上冷却,从而使热区域恶化。我们对80核服务器SOC的模拟发现,BSPDN可以提高热点温度E最高可达14°C。设计和技术调整(例如增加背部金属密度)可以改善这种情况,但是我们需要更多的疏远技术来完全防止它。准备“ CMOS 2.0” BSPDN是SO符合的硅逻辑技术新范式的一部分。这个新兴时期还将看到高级晶体管体系结构和专用逻辑层。这些技术的主要目的是优化芯片性能和功率效率,但它们还可以提供热销售,包括改善散热量。在当今的CMOS芯片中,单个晶体管向相邻和远处的组件驱动信号,从而导致无能。但是,如果有两层驱动器怎么办?一层将处理长线并使用专用晶体管缓冲这些连接;其他人只会处理低于10μm的连接。因为第二层中的晶体管将针对短连接进行优化,所以它们可以在较低的电压下运行,这将红色UCE电密度。但是,确切的值仍然不确定。将来,芯片成分将使用适合每个芯片的技术过程来处理自己的硅晶片。那么,只能仅使用P ProcationUrerInpon构建的SOC就能产生更好的SOC。但是工程师应仔细考虑热量如何流入新的3D结构。对于公司而言,解决该行业热量问题的IMEC是什么是跨学科的努力。没有技术(如果是热接口材料,晶体管,系统控制解决方案,包装或冷却器)可能会解决未来芯片的热问题。我们将需要所有这些。借助良好的仿真工具和评估,我们可以开始了解每个过程的应用量以及如何应用程序。尽管CMOS 2.0技术的热优点(尤其是背部和专注逻辑)似乎有望确认这些早期预测并仔细评估它们影响。例如,对于后技术,我们需要确切地了解它们是否会改变产生和散热,并且是否会产生更多的新问题。芯片设计人员可能倾向于采用新的半导体技术,因为以后可以在软件中处理意外的热问题。这可能是正确的,但是在一定程度上。由于这些解决方案自然不准确,因此过度依赖软件解决方案会影响芯片性能。例如,修复单个热点可能需要对较大区域的性能损害,否则较大的区域。用于建造它们的SOC和半导体技术应该在一起。好消息是,更多的EDA产品为先进的热分析增加了功能,包括芯片设计的早期阶段。专家还要求采取新的芯片开发策略,称为系统技术合作。 STCO旨在通过考虑系统,物理设计和过程技术来消除它们之间严格的抽象界限以全面的方式。深入的专家必须离开舒适区,并与其他芯片工程领域的专家合作。我们可能还不知道如何应对该行业更严重的热门挑战,但是我们对正确的工具和协作感到乐观,这可以做到。
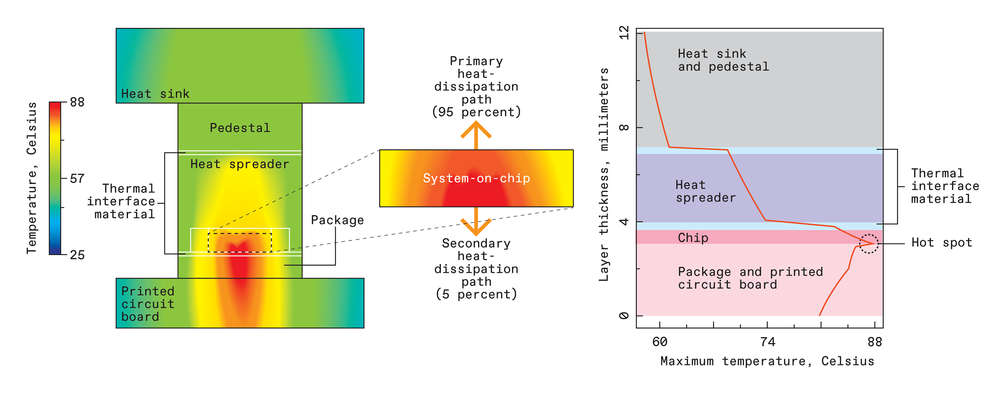 在5年以上,工程师设法在摩尔法律驱动的情况下,每两年封装一次在同一地区封装的晶体管数量增加一倍。但是,随着行业追求逻辑密度,不愉快的效果变得越来越好 - 已知:热量。本文指出:在CPU和GPU等片上(SOC)中,温度会影响性能,消耗和能源效率。随着时间的流逝,过多的热量会减慢关键处理器信号的传播,并导致芯片性能永久下降。这也会导致晶体管泄漏更多的电流,从而浪费功率。在这方面,增加电消耗可能会削弱芯片能源效率,因为执行完全相同的能量。问题的根源在于另一个法律的末尾:丹纳德缩放。该法律指出,随着晶体管的线性尺寸降低,必须降低电压,以使给定区域的总电量保持不变。GED。如果不影响整体晶体管功能,则在2000年代中期有效地完成了丹纳德缩放率,如果无法进一步降低电压。因此,即使逻辑回路的密度继续增长,功率密度也会增加,形成热量作为副产品。随着芯片变得更加紧凑和强大,预防良好的热量对于维持性能和使用寿命很重要。为了确保这种效率,我们需要一种工具来预测新的半导体技术(产生晶体管,互连和逻辑细胞的过程)如何改变热量的形成和去除方式。 IMEC研究同事和我开发了它。我们的仿真框架使用工业标准和开源电子设计自动化(EDA),并增强了我们的内部工具设置,以快速探索半导体技术与使用它开发的系统之间的相互作用。到目前为止,结果是不可避免的:热挑战的增加对于每个新技术节点,我们都需要新的解决方案,包括设计芯片和系统的新解决方案,如果他们希望能够应对热量。传统上,冷却极限是通过通过连接到包装的散热器开花空气来冷却SOC的。一些数据中心开始使用液体,因为它吸收的MAS比气体要多得多。液体冷却剂(通常是水基或水基混合物)可能适用于最新一代的高性能芯片,例如NVIDIA的新AI GPU,据报道,该芯片可消耗多达1,000瓦的功率。但是,风扇或液体冷却可能与即将到来的较小节点技术相匹配。当去除芯片的热量时,会遵循复杂的路径,但其中95%通过设备排放。 IMEC捕获了现场效应(CFET)中的纳米片晶体管和辅助晶体管。顶级芯片制造商转向纳米芯片设备,该设备将鳍转换为当今现场的晶体管效应一堆水平的半导体芯片。 CFET将这种体系结构带到了极端,并用Patayo堆叠了更多的床单,并将两个设备分开,从而使两个晶体管与晶体管大致相同。专家预计,半导体行业将在2030年代引入CFET。在我们的工作中,我们查看了即将到来的Nanosheet A10版本(指10 angstrom或1 nm节点)和一个名为A5的CFET版本,IMEC希望在A10之后出现两代人。我们测试设计的仿真表明,A5节点的功率密度比A10节点高12%至15%。在相同的工作电压下,增加该密度将导致9°C的估计温度升高。晶体管的完整作用覆盖了彼此上方的纳米片晶体管,从而增加了密度和温度。要在类似于纳米片晶体管(A10节点)的相同温度下操作,CFET(A5节点)应在还原的电压下运行年龄。 IMEC Company 9学位可能不会太多。但是,在数据中心,将数千至数百万芯片包裹在一起的数据中心,这可能意味着稳定操作和热失控之间的差异,即可怕的反馈回路,温度增加泄漏,温度升高,以防止永久损害。研究人员正在寻找基本液体和冷却空气的先进替代品,以帮助缓解极端的高温。例如,微流体冷却使用与芯片绑定的小通道来旋转设备内的液体冷却液。其他程序包括喷气撞击,包括在芯片上高速的气体或Likido,并冷却浸入,将整个印刷电路板浸入冷却液浴中。但是,即使这些新技术开始起作用,只依靠冷却器释放过多的热量可能并不实际。对于仅限尺寸,重量,蝙蝠的移动系统尤其如此ry力量,不需要用户烹饪。同时,数据中心面临着各种限制:由于冷却是整个建筑物基础设施的成本,因此每次到达新芯片时更新冷却的冷却,它非常昂贵且非常具有破坏性。与热量相比,性能与幸运的是,冷却技术并不是阻止炸薯条油炸的唯一方法。各种系统级解决方案可以通过动态新的适应变化的热条件来控制热量。一种方法是将热传感器放置在芯片周围。当传感器检测到升高温度的升高时,它们会释放出降低电压和工作频率的信号,从而降低电力消耗以抵消热量。但是,尽管这样的解决方案解决了散热问题,但它可能会显着影响芯片性能。例如,芯片在热环境中总是可以效果不佳,例如任何人放置智能的证据白天。另一种称为Hot Sprint的技术对于多核数据中心CPU特别有用。这是通过运行核心直到过热的核心来完成的,然后在第一个核心冷却时将其移至第二核。这个过程是xtimime的性能,但是当任务应在许多内核之间移动以执行更长的活动时,可能会导致延迟。热冲刺也减少了整体芯片吞吐量,因为冷却时芯片的某些部分总是被禁用。因此,系统级解决方案需要在热量和性能之间进行仔细的平衡。为了有效地应用它们,SOC设计师必须对芯片中的功率分布,热点出现,传感器的放置位置,电压或频率降低的位置以及某些芯片零件冷却所需的时间。但是,即使是最好的芯片设计师,也很快就需要更具创意的方法SA热门管理。有希望偷走的意图他的芯片背面包括在晶圆的底部或背面添加新功能。这种方法主要旨在改善电力传递和计算性能。但这也可以帮助解决一些卡路里问题。新技术可以降低需要传递到多核处理器的电压,从而使芯片在以可接受的频率运行时保持最小电压。背面动力网络通过降低电阻来做到这一点。后电容器减少了瞬态电压损耗。后部允许根据需要在不同最小电压下运行的不同芯的组合调节器。 IMEC公司IMEC遇到了许多后方技术,这些技术可能使芯片与较低的Bointage一起工作,从而减少了它们的热量。路线图中的第一个技术是So值的后端电源网络(BSPDN),该技术的名称可以:它将电源线从芯片的前端移动到后方。所有高级CMOS铸造计划在2026年底之前提供BSPDN。先前的示威活动表明,它们通过将电源更接近晶体管来降低阻力。电阻越小,电压损耗越小,这意味着芯片可以用降低的输入电压工作。当电压降低时,功率密度降低并且温度下降。通过更换散热路径上的材料,后递送技术可以使芯片中的热点更热。 IMEC在BSPDN之后,制造商可以添加具有高储能容量的电容器。在高性能的SOC中,由印刷电路板和芯片包上的电感引起的大电压波可能是有问题的。重新塑造电容器应帮助解决此问题,因为它们靠近晶体管,使它们能够吸收电压尖峰并更快地变化。因此,这种布置将提供芯片以在较低的电压和温度下运行,而仅比BSPDN使用。最后,芯片制造商WILL启动后部集成电压调节器(IVR)电路。该技术旨在通过调整更优惠的电压来进一步降低芯片电压需求。例如,用于智能手机的SOC通常具有8个或MORECOUTE的内核,但是没有芯片室可以拥有自己的离散调节器。取而代之的是,不管所有四个芯都面对相同的计算负载,片外调节器通常会一起管理四个芯的电压。另一方面,IVR将通过专用电路来管理每个核心统一,从而能量能量。将它们放在后面可以节省重要的前部空间。目前尚不清楚技术如何影响热管理;需要示范和仿真来绘制渲染。添加新技术通常会增加电力密度,而芯片设计人员需要考虑热后果。例如,将后部IVR放置时,如果IVR分布在Nequal等效上,或者如果它们集中在某个位置(SUC),则热问题会改善H作为每个核心和缓存内存的中心)?最近,我们已经表明,即使解决了旧的热问题,也可以引入强度的后备引入新的热问题。原因是创建BSPDN时留下的硅层变得越来越薄。在前设计中,硅基板的厚度可以达到750微米。由于硅具有良好的导热率,因此该相对压倒性的层通过横向分散晶体管的热量来帮助控制热区域。但是,将技术添加到后部需要将基板变薄至约1μm,以便从后部与晶体管相互作用。在两层电线和绝缘子之间刮擦,这种细长的硅晶片不再有效地将热量移至两侧。因此,超级活性晶体管的热量可以在本地捕获并强迫向上冷却,从而使热区域恶化。我们对80核服务器SOC的模拟发现,BSPDN可以提高热点温度E最高可达14°C。设计和技术调整(例如增加背部金属密度)可以改善这种情况,但是我们需要更多的疏远技术来完全防止它。准备“ CMOS 2.0” BSPDN是SO符合的硅逻辑技术新范式的一部分。这个新兴时期还将看到高级晶体管体系结构和专用逻辑层。这些技术的主要目的是优化芯片性能和功率效率,但它们还可以提供热销售,包括改善散热量。在当今的CMOS芯片中,单个晶体管向相邻和远处的组件驱动信号,从而导致无能。但是,如果有两层驱动器怎么办?一层将处理长线并使用专用晶体管缓冲这些连接;其他人只会处理低于10μm的连接。因为第二层中的晶体管将针对短连接进行优化,所以它们可以在较低的电压下运行,这将红色UCE电密度。但是,确切的值仍然不确定。将来,芯片成分将使用适合每个芯片的技术过程来处理自己的硅晶片。那么,只能仅使用P ProcationUrerInpon构建的SOC就能产生更好的SOC。但是工程师应仔细考虑热量如何流入新的3D结构。对于公司而言,解决该行业热量问题的IMEC是什么是跨学科的努力。没有技术(如果是热接口材料,晶体管,系统控制解决方案,包装或冷却器)可能会解决未来芯片的热问题。我们将需要所有这些。借助良好的仿真工具和评估,我们可以开始了解每个过程的应用量以及如何应用程序。尽管CMOS 2.0技术的热优点(尤其是背部和专注逻辑)似乎有望确认这些早期预测并仔细评估它们影响。例如,对于后技术,我们需要确切地了解它们是否会改变产生和散热,并且是否会产生更多的新问题。芯片设计人员可能倾向于采用新的半导体技术,因为以后可以在软件中处理意外的热问题。这可能是正确的,但是在一定程度上。由于这些解决方案自然不准确,因此过度依赖软件解决方案会影响芯片性能。例如,修复单个热点可能需要对较大区域的性能损害,否则较大的区域。用于建造它们的SOC和半导体技术应该在一起。好消息是,更多的EDA产品为先进的热分析增加了功能,包括芯片设计的早期阶段。专家还要求采取新的芯片开发策略,称为系统技术合作。 STCO旨在通过考虑系统,物理设计和过程技术来消除它们之间严格的抽象界限以全面的方式。深入的专家必须离开舒适区,并与其他芯片工程领域的专家合作。我们可能还不知道如何应对该行业更严重的热门挑战,但是我们对正确的工具和协作感到乐观,这可以做到。
在5年以上,工程师设法在摩尔法律驱动的情况下,每两年封装一次在同一地区封装的晶体管数量增加一倍。但是,随着行业追求逻辑密度,不愉快的效果变得越来越好 - 已知:热量。本文指出:在CPU和GPU等片上(SOC)中,温度会影响性能,消耗和能源效率。随着时间的流逝,过多的热量会减慢关键处理器信号的传播,并导致芯片性能永久下降。这也会导致晶体管泄漏更多的电流,从而浪费功率。在这方面,增加电消耗可能会削弱芯片能源效率,因为执行完全相同的能量。问题的根源在于另一个法律的末尾:丹纳德缩放。该法律指出,随着晶体管的线性尺寸降低,必须降低电压,以使给定区域的总电量保持不变。GED。如果不影响整体晶体管功能,则在2000年代中期有效地完成了丹纳德缩放率,如果无法进一步降低电压。因此,即使逻辑回路的密度继续增长,功率密度也会增加,形成热量作为副产品。随着芯片变得更加紧凑和强大,预防良好的热量对于维持性能和使用寿命很重要。为了确保这种效率,我们需要一种工具来预测新的半导体技术(产生晶体管,互连和逻辑细胞的过程)如何改变热量的形成和去除方式。 IMEC研究同事和我开发了它。我们的仿真框架使用工业标准和开源电子设计自动化(EDA),并增强了我们的内部工具设置,以快速探索半导体技术与使用它开发的系统之间的相互作用。到目前为止,结果是不可避免的:热挑战的增加对于每个新技术节点,我们都需要新的解决方案,包括设计芯片和系统的新解决方案,如果他们希望能够应对热量。传统上,冷却极限是通过通过连接到包装的散热器开花空气来冷却SOC的。一些数据中心开始使用液体,因为它吸收的MAS比气体要多得多。液体冷却剂(通常是水基或水基混合物)可能适用于最新一代的高性能芯片,例如NVIDIA的新AI GPU,据报道,该芯片可消耗多达1,000瓦的功率。但是,风扇或液体冷却可能与即将到来的较小节点技术相匹配。当去除芯片的热量时,会遵循复杂的路径,但其中95%通过设备排放。 IMEC捕获了现场效应(CFET)中的纳米片晶体管和辅助晶体管。顶级芯片制造商转向纳米芯片设备,该设备将鳍转换为当今现场的晶体管效应一堆水平的半导体芯片。 CFET将这种体系结构带到了极端,并用Patayo堆叠了更多的床单,并将两个设备分开,从而使两个晶体管与晶体管大致相同。专家预计,半导体行业将在2030年代引入CFET。在我们的工作中,我们查看了即将到来的Nanosheet A10版本(指10 angstrom或1 nm节点)和一个名为A5的CFET版本,IMEC希望在A10之后出现两代人。我们测试设计的仿真表明,A5节点的功率密度比A10节点高12%至15%。在相同的工作电压下,增加该密度将导致9°C的估计温度升高。晶体管的完整作用覆盖了彼此上方的纳米片晶体管,从而增加了密度和温度。要在类似于纳米片晶体管(A10节点)的相同温度下操作,CFET(A5节点)应在还原的电压下运行年龄。 IMEC Company 9学位可能不会太多。但是,在数据中心,将数千至数百万芯片包裹在一起的数据中心,这可能意味着稳定操作和热失控之间的差异,即可怕的反馈回路,温度增加泄漏,温度升高,以防止永久损害。研究人员正在寻找基本液体和冷却空气的先进替代品,以帮助缓解极端的高温。例如,微流体冷却使用与芯片绑定的小通道来旋转设备内的液体冷却液。其他程序包括喷气撞击,包括在芯片上高速的气体或Likido,并冷却浸入,将整个印刷电路板浸入冷却液浴中。但是,即使这些新技术开始起作用,只依靠冷却器释放过多的热量可能并不实际。对于仅限尺寸,重量,蝙蝠的移动系统尤其如此ry力量,不需要用户烹饪。同时,数据中心面临着各种限制:由于冷却是整个建筑物基础设施的成本,因此每次到达新芯片时更新冷却的冷却,它非常昂贵且非常具有破坏性。与热量相比,性能与幸运的是,冷却技术并不是阻止炸薯条油炸的唯一方法。各种系统级解决方案可以通过动态新的适应变化的热条件来控制热量。一种方法是将热传感器放置在芯片周围。当传感器检测到升高温度的升高时,它们会释放出降低电压和工作频率的信号,从而降低电力消耗以抵消热量。但是,尽管这样的解决方案解决了散热问题,但它可能会显着影响芯片性能。例如,芯片在热环境中总是可以效果不佳,例如任何人放置智能的证据白天。另一种称为Hot Sprint的技术对于多核数据中心CPU特别有用。这是通过运行核心直到过热的核心来完成的,然后在第一个核心冷却时将其移至第二核。这个过程是xtimime的性能,但是当任务应在许多内核之间移动以执行更长的活动时,可能会导致延迟。热冲刺也减少了整体芯片吞吐量,因为冷却时芯片的某些部分总是被禁用。因此,系统级解决方案需要在热量和性能之间进行仔细的平衡。为了有效地应用它们,SOC设计师必须对芯片中的功率分布,热点出现,传感器的放置位置,电压或频率降低的位置以及某些芯片零件冷却所需的时间。但是,即使是最好的芯片设计师,也很快就需要更具创意的方法SA热门管理。有希望偷走的意图他的芯片背面包括在晶圆的底部或背面添加新功能。这种方法主要旨在改善电力传递和计算性能。但这也可以帮助解决一些卡路里问题。新技术可以降低需要传递到多核处理器的电压,从而使芯片在以可接受的频率运行时保持最小电压。背面动力网络通过降低电阻来做到这一点。后电容器减少了瞬态电压损耗。后部允许根据需要在不同最小电压下运行的不同芯的组合调节器。 IMEC公司IMEC遇到了许多后方技术,这些技术可能使芯片与较低的Bointage一起工作,从而减少了它们的热量。路线图中的第一个技术是So值的后端电源网络(BSPDN),该技术的名称可以:它将电源线从芯片的前端移动到后方。所有高级CMOS铸造计划在2026年底之前提供BSPDN。先前的示威活动表明,它们通过将电源更接近晶体管来降低阻力。电阻越小,电压损耗越小,这意味着芯片可以用降低的输入电压工作。当电压降低时,功率密度降低并且温度下降。通过更换散热路径上的材料,后递送技术可以使芯片中的热点更热。 IMEC在BSPDN之后,制造商可以添加具有高储能容量的电容器。在高性能的SOC中,由印刷电路板和芯片包上的电感引起的大电压波可能是有问题的。重新塑造电容器应帮助解决此问题,因为它们靠近晶体管,使它们能够吸收电压尖峰并更快地变化。因此,这种布置将提供芯片以在较低的电压和温度下运行,而仅比BSPDN使用。最后,芯片制造商WILL启动后部集成电压调节器(IVR)电路。该技术旨在通过调整更优惠的电压来进一步降低芯片电压需求。例如,用于智能手机的SOC通常具有8个或MORECOUTE的内核,但是没有芯片室可以拥有自己的离散调节器。取而代之的是,不管所有四个芯都面对相同的计算负载,片外调节器通常会一起管理四个芯的电压。另一方面,IVR将通过专用电路来管理每个核心统一,从而能量能量。将它们放在后面可以节省重要的前部空间。目前尚不清楚技术如何影响热管理;需要示范和仿真来绘制渲染。添加新技术通常会增加电力密度,而芯片设计人员需要考虑热后果。例如,将后部IVR放置时,如果IVR分布在Nequal等效上,或者如果它们集中在某个位置(SUC),则热问题会改善H作为每个核心和缓存内存的中心)?最近,我们已经表明,即使解决了旧的热问题,也可以引入强度的后备引入新的热问题。原因是创建BSPDN时留下的硅层变得越来越薄。在前设计中,硅基板的厚度可以达到750微米。由于硅具有良好的导热率,因此该相对压倒性的层通过横向分散晶体管的热量来帮助控制热区域。但是,将技术添加到后部需要将基板变薄至约1μm,以便从后部与晶体管相互作用。在两层电线和绝缘子之间刮擦,这种细长的硅晶片不再有效地将热量移至两侧。因此,超级活性晶体管的热量可以在本地捕获并强迫向上冷却,从而使热区域恶化。我们对80核服务器SOC的模拟发现,BSPDN可以提高热点温度E最高可达14°C。设计和技术调整(例如增加背部金属密度)可以改善这种情况,但是我们需要更多的疏远技术来完全防止它。准备“ CMOS 2.0” BSPDN是SO符合的硅逻辑技术新范式的一部分。这个新兴时期还将看到高级晶体管体系结构和专用逻辑层。这些技术的主要目的是优化芯片性能和功率效率,但它们还可以提供热销售,包括改善散热量。在当今的CMOS芯片中,单个晶体管向相邻和远处的组件驱动信号,从而导致无能。但是,如果有两层驱动器怎么办?一层将处理长线并使用专用晶体管缓冲这些连接;其他人只会处理低于10μm的连接。因为第二层中的晶体管将针对短连接进行优化,所以它们可以在较低的电压下运行,这将红色UCE电密度。但是,确切的值仍然不确定。将来,芯片成分将使用适合每个芯片的技术过程来处理自己的硅晶片。那么,只能仅使用P ProcationUrerInpon构建的SOC就能产生更好的SOC。但是工程师应仔细考虑热量如何流入新的3D结构。对于公司而言,解决该行业热量问题的IMEC是什么是跨学科的努力。没有技术(如果是热接口材料,晶体管,系统控制解决方案,包装或冷却器)可能会解决未来芯片的热问题。我们将需要所有这些。借助良好的仿真工具和评估,我们可以开始了解每个过程的应用量以及如何应用程序。尽管CMOS 2.0技术的热优点(尤其是背部和专注逻辑)似乎有望确认这些早期预测并仔细评估它们影响。例如,对于后技术,我们需要确切地了解它们是否会改变产生和散热,并且是否会产生更多的新问题。芯片设计人员可能倾向于采用新的半导体技术,因为以后可以在软件中处理意外的热问题。这可能是正确的,但是在一定程度上。由于这些解决方案自然不准确,因此过度依赖软件解决方案会影响芯片性能。例如,修复单个热点可能需要对较大区域的性能损害,否则较大的区域。用于建造它们的SOC和半导体技术应该在一起。好消息是,更多的EDA产品为先进的热分析增加了功能,包括芯片设计的早期阶段。专家还要求采取新的芯片开发策略,称为系统技术合作。 STCO旨在通过考虑系统,物理设计和过程技术来消除它们之间严格的抽象界限以全面的方式。深入的专家必须离开舒适区,并与其他芯片工程领域的专家合作。我们可能还不知道如何应对该行业更严重的热门挑战,但是我们对正确的工具和协作感到乐观,这可以做到。
